化合物半導体材料の個片化(SnB加工)
_キャッチ画像_ロゴ付.png)
SnB加工とは、ガラスなどの脆性材料の割断に用いられる加工方法である『スクライビング アンド ブレイキング(Scribing and Breaking)加工』の略称です。
液晶ガラス基板などの硬脆性材料の割断にも広く用いられてきましたが、MDIでは独自のスクライビングホイールの開発を行い、化合物半導体材料の割断に応用範囲を拡げました。
化合物半導体とは
2種類以上の元素が結合してできる半導体のことです。複数の異なる元素が組み合わさっており、単元素の半導体では実現できない特性を得ることができます。さらに、元素の混合比を変えることにより、その特性を調整することが可能な材料です。このような特性を活かして多くの種類の半導体が作成されています。
《主な化合物半導体の組み合わせ》
| Ⅱ-Ⅳ族 | テルル化カドミウム(CdTe), セレン化亜鉛(ZnSe) |
| Ⅲ-Ⅴ族 | 窒化ガリウム(GaN), ヒ化ガリウム(GaAs), 窒化アルミニウム(AlN), リン化インジウム(InP) |
| Ⅳ-Ⅳ族 | 炭化ケイ素(SiC), シリコンゲルマニウム(SiGe) |
これらの化合物半導体は基本的に共有結合結晶で、多くは閃亜鉛鉱型構造やウルツ鉱型構造を有します。酸化ガリウム(Ga2O3)は酸化物半導体に分類されます。
SnB加工の特長
①カーフロスが極小
スクライビングホイールによるSnB加工では、スクライビングによるグルーブ幅(塑性変形領域の一部)が約5μm程度です。そのため、半導体・電子部品では基板のストリート幅を狭くすることができ、基板1枚当たりの製品取数を増加させることが可能です。
※ストリート幅は30μm以下にも対応可能
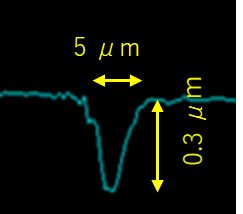
②高速加工
SnB加工のスクライビング加工速度は100mm/s~500mm/sと高速です。時間当たりの処理基板枚数を多くすることで、生産に必要な装置台数を抑えることが可能です。
③ダメージフリー
SnB加工は割断法であるため、基板へのダメージはスクライビングによる加工痕のみです。断面は平滑な破断面を持つため、他の個片化法と比べて断面にクラックが発生しにくく、製品(チップ)の抗折強度が高くなります。
※結晶構造を持つ基材の場合、断面は劈開面となり結晶構造が保持されているため、サイドクラックが発生しません
④ドライプロセス
半導体製造工程では多くの水を必要としますが、SnB加工は基本的に水を使用しないドライプロセスです。貴重な水資源を使用しない環境に優しい加工方法で、洗浄水供給や排水処理用の付帯設備も不要、コストを抑えることができます。
MDI wheel scribing
wheel scribing(スクライビング)とは
分離予定線に沿ってScribing wheelから表層に圧力を付加し、垂直のクラックを生成します。このクラックによって、Breakingによる亀裂進展が可能となります。
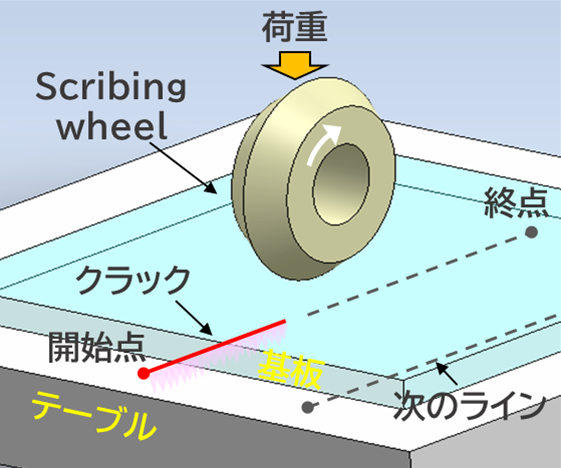
他のメカニカル加工法であるブレードダイシングとの比較

スクライビングホイールは全て自社開発、自社工場のクリーンルーム内で製造しています。スクライビングホイールは加工対象の材質や製品サイズなどに合わせて、適切な選定を行います。

MDI Breaking
基板はブレイキングによって個片化されます。スクライビングで与えた垂直クラックを、逆の面からブレイクバーで押し込み、進展させ割断します。結晶構造を持つ素材では、劈開(cleavage)を利用することになります。そのため、断面は微細にも平滑な割断面(結晶構造では劈開面)を持ち、断面のクラックが発生しません。
※結晶構造が保持されるため、断面は鏡面とはならず、結晶構造に従い凹凸になります
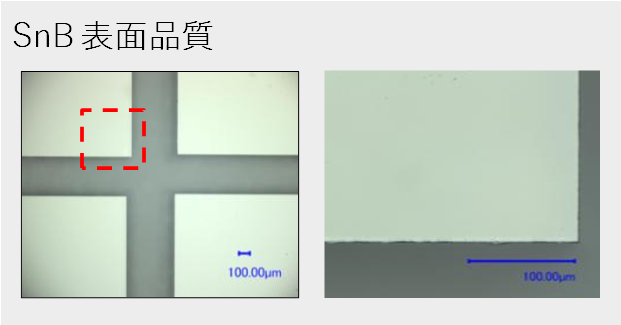
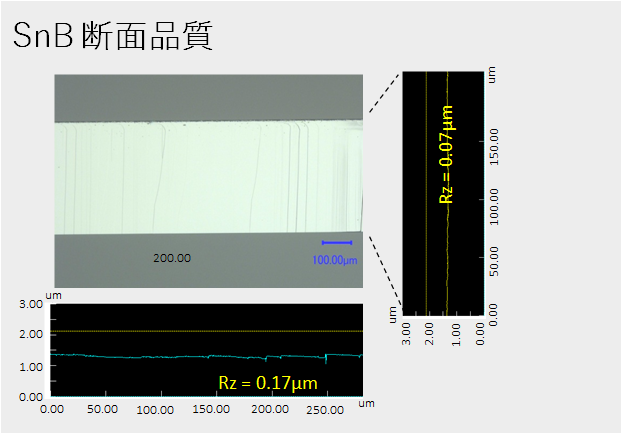
SnB加工事例
Ⅳ-Ⅳ族:炭化ケイ素(SiC)
厚み:0.36mm, 加工サイズ:1.0×1.0mm
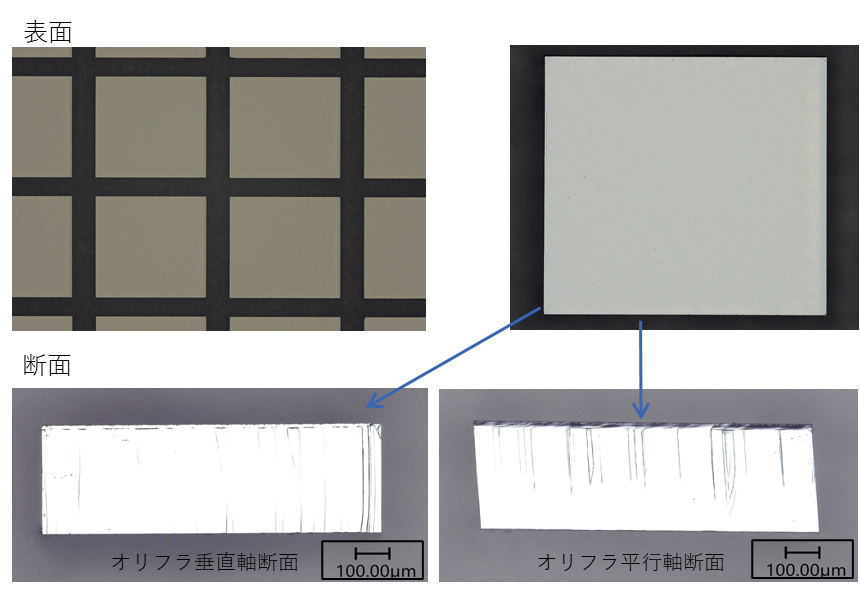
Ⅲ-Ⅴ族:窒化ガリウム(GaN)
厚み:0.45mm
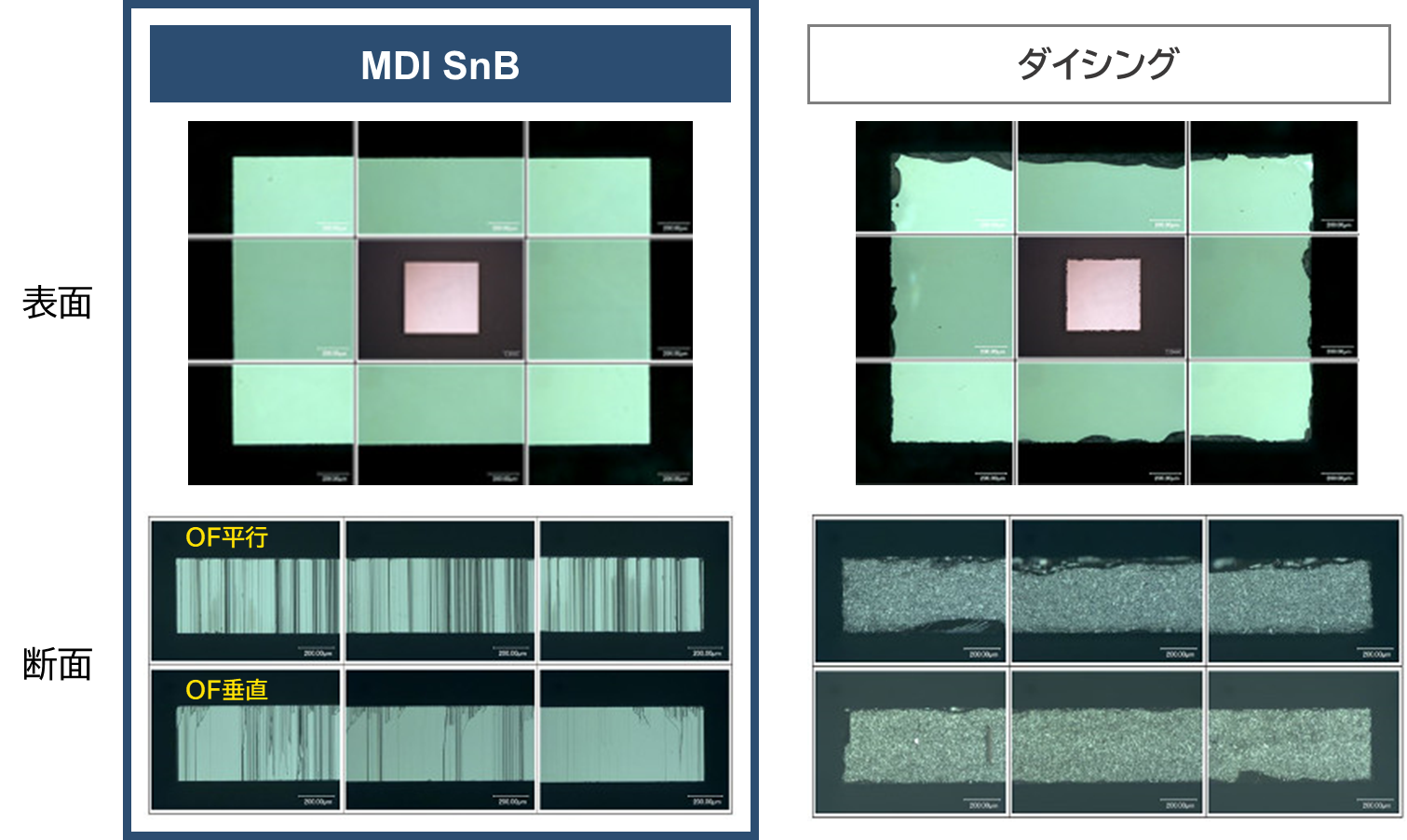
Ⅲ-Ⅴ族:ヒ化ガリウム(GaAs)
厚み:0.1mm, 加工サイズ:0.7mm×0.75mm
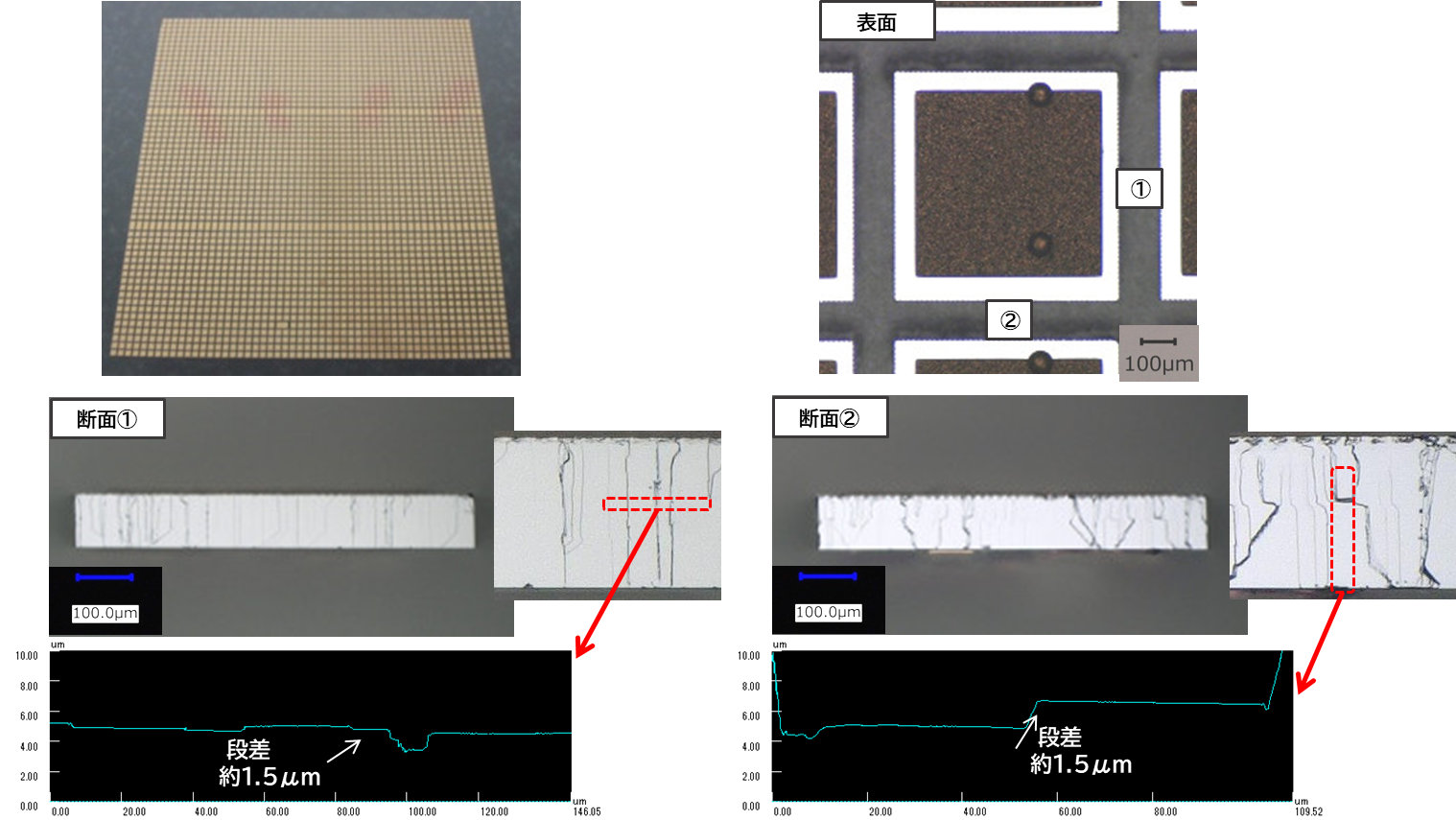
Ⅲ-Ⅴ族:リン化インジウム(InP)
厚み:0.15mm, 加工サイズ:0.4mm×0.4mm
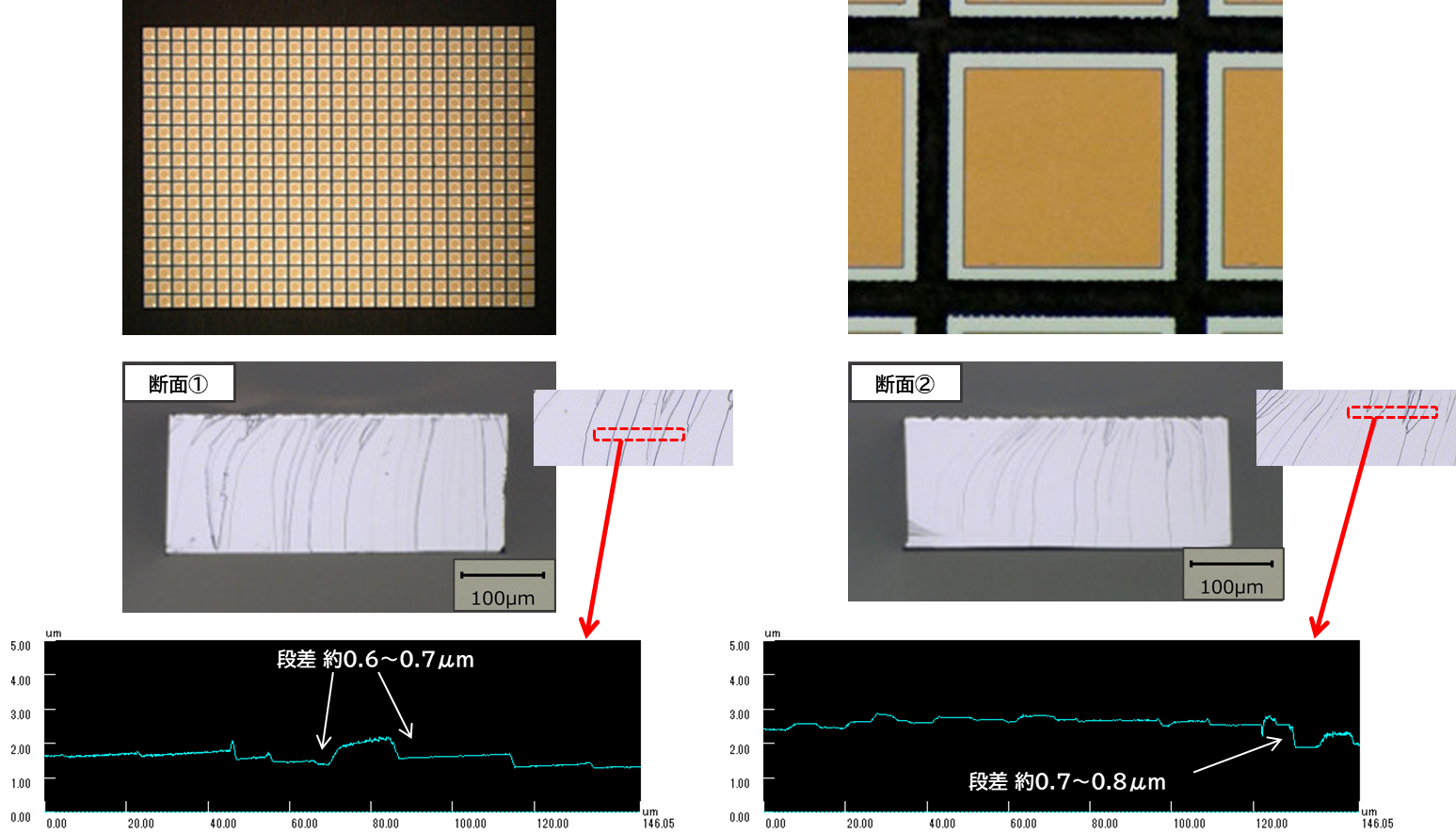
関連ページへのリンク
上記製品・サービス等に関するお問い合わせ
ホームページからのお問い合わせは、下記リンク先の「お問い合わせフォーム」をお使いください。










